光刻模組
Nanoscribe 3D 打印機 (PHT-P1)
潔凈/半潔凈/非常規
Specifications
| Resolution (depends on the objective lens and resist) | : |
- 3D lateral feature size: ≤200 nm - 2D lateral resolution: ≤500 nm - Vertical resolution: ≤1,500 nm |
|||||||||||||||||||||||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Speed | : |
- Beam scanning speed: 10 mm/s - Piezo scanning speed: 100 µm/s |
|||||||||||||||||||||||||||||||||
| Range | : | - Motorized xy scanning stage range: 100 x 100 mm² -x-y-z piezo range: 300 x 300 x 300 µm³ -x-y galvo scan range 200 - 1000 µm Ø dependent on scanning objective |
|||||||||||||||||||||||||||||||||
| Maximum structure height | : | - IP-Q 10x lens DiLL: 8 mm - IP-S 25x lens DiLL: 3 mm - IP DiP 63x lens DiLL: 3 mm - Oil immersion with 170 µm glass: 150 µm |
|||||||||||||||||||||||||||||||||
| Minimum feature size | : | -10x lens: ~2 µm x, y and ~10 µm z -25x lens: 0.6 µm x, y and ~3.3 µm z -63x lens: 150 nm x, y and 800 nm z |
|||||||||||||||||||||||||||||||||
| Objectives | : | 1. Immersion Objective: 63x, NA=1.4; WD=190 um, for high-resolution structures, printing field (Galvo Ø) = 200 um; Typical slicing distance = 0.3 µm; Typical hatching distance=0.2 µm 2. Immersion Objective: 25x; NA=0.8; WD=380 um, for mesoscale structures; Printing field (Gavle Ø) = 400 µm; Typical slicing distance =1 µm; Typical hatching distance=0.5 µm 3. Air Objective: 20x, NA=0.5; WD=2100 um, for 2D maskless lithography; Printing field (Galvo Ø) = 600 µm; Typical slicing distance=3-6 µm; Typical hatching distance= 0.7-1.2 µm 4. Immersion Objective: 10x, NA=0.3; WD=700 um, for rapid prototyping; Printing field (Galvo Ø) =1000 µm; Typical slicing distance= 5 µm; Typical hatching distance =1 µm |
|||||||||||||||||||||||||||||||||
| Sample holders | : |
|
|||||||||||||||||||||||||||||||||
| Printing configuration | : |
|
ASML Stepper 步進光刻機 (PHT-S1)
潔凈/半潔凈
Karl Suss Bonder XB8 晶片鍵合機 (PHT-B2)
非常規
Specifications
| Adhesive, Anodic, Eutectic bonding and Silicon fusion prebonding | ||
|---|---|---|
| Wafer size | : | > 2 cm x 2 cm, 4", 6" & 8" |
| Substrate material | : | Silicon or Pyrex Glass |
| Pressure | : | 1x10e-5 mbar to 3 bars |
| Bonding force | : | 3500 N ~ 100K N (8") |
| Temperature | : | RT to 500 ºC |
| Controllable Voltage range | : | 0 – 2000 V |
| Controllable Current range | : | 0-15 mA |
SET ACCµRA100 倒裝貼片機 (PHT-B3)
非常規
Karl Suss MA6 #1 and #2 光刻機(PHT-A5及PHT-A7)
潔凈/半潔凈/非常規
Specifications
| Light source illumination | : | i-line (365 nm) |
|---|---|---|
| Resolution | : | 1 um |
| Substrate size | : | > 5 mm2 to 2" or 4” |
| Photomask size | : | 5” square |
| Exposure modes | : | Contact (soft, hard, low vacuum and Vacuum) Proximity (exposure gap 1-300um); Flood Exposures |
| Alignment methods | : | Top Side Alignment (TSA); Bottom Side Alignment (BSA) |
| Alignment accuracy | : | TSA (down to 0.5 µm); BSA (down to 1 µm) |
| No. of machines installed | : | 2 |
AB-M Aligner #1 (UV)/(DUV) and #2 (UV) 接觸式光刻機(PHT-A1及PHT-A2)
半潔凈/非常規
Specifications
| Light source illumination | : | DUV / UV wavelength selectable (500W Mercury DUV lamp) |
|---|---|---|
| Alighment printing mode | : | Manual |
| Soft contact | : | Contact vacuum adjustable |
| Hard contact | : | Full vacuum contact |
| Photomask | : | 5" square or 7" square |
| Substrate size | : | > 5 mm2 to 4" square, or 6" |
| Special feature | : | Backside alignment using Infra-red |
| No. of machines installed | 2 |
SVG88 Coater Track and SVG88 Developer Track 塗膠機(PHT-T1及PHT-T2)
潔凈/半潔凈
Specifications
| Automatic tracks for resist coating and developing | ||
|---|---|---|
| No. of tracks | : | 2 |
| Coat track feature | : | Vapor prime chill plate |
| : | Coat module Backside rinse |
|
| : | Frontside edge bead remover 2 hot plate ovens |
|
| Develop track | : | Developer module, chill plate, 2 hot plate ovens |
| Coating uniformity | : | ± 0.3 % |
| Wafer size | : | 4" and 6" |
| Wafer loading/unloading | : | Cassette to cassette |
EVG Spray Coater 噴霧式塗膠機(PHT-SC5)
潔凈/半潔凈/非常規
Specifications
| Speed range | : | up to 10000 rpm |
|---|---|---|
| Ramp up speed | : | 0-40000 rpm/s |
| Heat chuck temperature | : | up to 70 ± 1 oC |
| Spray speed integrate with heat chuck | : | < 1500 rpm |
| Spray coating nozzle | : | Ultrasonic Atomizer Nozzle |
| Syringe dispense rate | : | 0.01 ml/s to 5 ml/s |
| Substrate size | : | Up to 200 mm or 150 mm x 150 mm |
SUSS Coater 手動塗膠機(PHT-SC1)
半潔凈/非常規
CEE Coater 手動塗膠機及加熱台(PHT-SC3)
潔凈/半潔凈
Desktop Coater 桌上式手動塗膠機(PHT-SC2)
非常規
Solitec Coater #1 塗膠機(PHT-SC4)
非常規
High Temperature Conventional Oven 高溫烘箱(PHT-O1至PHT-O4;PHT-O6 至PHT-O9)
潔凈/半潔凈/非常規
Vacuum Oven 真空烘箱(PHT-O5)
非常規
Unitemp Reflow Oven 回流焊爐(PHT-O11) (只供PHT-B3 倒裝貼片機用戶使用)
Non-Standard
Specifications
| Reflow Soldering (with Formic Acid Option) | ||
|---|---|---|
| Substrate size | : | Fragments to 160 mm |
| Substrate Thickness | : | Up to 10 mm |
| Vacuum Range | : | Atmosphere to 10-3 hPa or mbar |
| Oven Temperature | : | Ambient to 350oC |
| Ramp Up Rate | : | Up to 120 K/min |
| Gas Flow Control | : | Nitrogen at max. 5 normal litre per min |
Nikon IC Inspection Microscope with Digital Camera 數字顯微鏡(PHT-MIC1)
Hot Plates 加熱台(PHT-HP1至PHT-HP8)
潔凈/半潔凈/非常規
Laurell PDMS Coater 塗膠機 (PHT-SC6) (只供做微流體工藝的用戶使用)
非常規
Kurabo PDMS Mixer/Deaerator 攪拌/脫泡機 (PHT-MX1) (只供做微流體工藝的用戶使用)
非常規

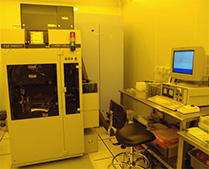
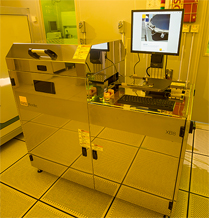
_small.jpg)